半导体所在MEMS器件低成本圆片级低温键合方法的研究方面取得重要进展
2011-04-20
封装是微纳机电系统(MEMS/NEMS)产业化前最后的但决定器件成败的最关键的一步加工技术,最近几年已经引起了越来越多的关注。当前国际上MEMS/NEMS较为成熟的封装工艺为键合工艺,几个发展比较成熟的键合都需要在高温条件下进行。高温会对MEMS传感器产生不良的影响,造成器件不稳定甚至失效。因此,急需开发适用于MEMS传感器的低温键合工艺。近几年,随着生化传感器和射频器件的快速发展,对低温键合封装的需求日益增强。
局域加热键合技术是低温键合技术之一,由于键合过程中只对需要键合的区域进行局部加热,芯片的其他部分仍处于较低温度,而且键合速度快,热应力小,大大提高了封装的可靠性。目前, 基于Au-Sn二元系的局域加热低温键合集中在 Au:Sn=80:20区域,且Au-Sn厚度>8μm,Au用量大,键合成本高。
半导体所集成技术工程研究中心相关课题组近期在基于Au-Sn二元系中富Sn区域的局域加热键合装置、键合方法及机理研究方面开展了一系列的工作,取得了重要进展。在Au:Sn比为46:54和30:70的成分范围,键合层厚度小于3μm,Au厚度<0.7μm,键合区温度280-310°C,成功获得了以具有高维氏硬度的AuSn2相为主的中间层,实现了键合强度>20MPa,最高达64MPa,为MEMS领域提供了一种高键合强度、高水密性、气密性、低成本的圆片级低温键合方法。这一方法简单、可靠、适合大规模加工工艺,它的成功应用将大大降低MEMS器件和系统的制作成本。
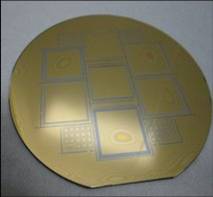

基于Au-Sn二元系中富Sn区域的圆片级局域加热键合及其中间层相组成
(韩伟华供稿)





